蚀刻性能:需要考虑的 9 个因素
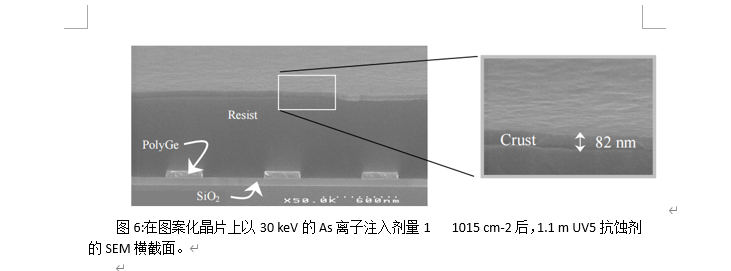
文章图片
通常在蚀刻过程之后通过将总厚度变化除以蚀刻时间或者通过对不同的蚀刻时间进行几次厚度测量并使用斜率的“最佳拟合”来测量 , 当怀疑蚀刻速率可能不随时间呈线性或蚀刻开始可能有延迟时 , 这样做有时可以实时测量蚀刻速率 。
蚀刻速度应与应用相称 , 需要非常浅的蚀刻的应用应该具有相对低的蚀刻速率以保持控制 , 相反对于具有非常深的特征的应用 , 实际上蚀刻速率更快以避免冗长的处理时间 。 重要的是要认识到其他参数会影响蚀刻速率 , 例如开口面积的大小或结构的纵横比(特征宽度/特征深度) , 当调整蚀刻速率时 , 在均匀性、轮廓或选择性之间也可能存在折衷 , 纵横比也影响蚀刻速率 , 因为纵横比越大 , 蚀刻速率越慢 。
蚀刻中的均匀性是对特定参数下整个晶片一致性的度量 , 通常 , 均匀性是指蚀刻速率 , 但它也可以指其他蚀刻后特征 , 如选择性和轮廓 , 由于数据是测量值的集合 , 因此通常使用统计数据 , 通过标准偏差来确定数据的分布 , 通常将一致性称为一个、两个或三个西格玛 , 另一种方法是使用公式((最大值-最小值)/2 x平均值) , 必须记住识别由于箝位或其他边缘效应而应排除度量的区域 。
轮廓是指已经被蚀刻的特征的轮廓或斜率 , 有些应用需要垂直剖面 , 有些应用需要倾斜剖面 , 当开发一个规范时 , 概要文件经常被作为要考虑的参数之一 , 轮廓控制是材料、工艺和掩模的函数 。 选择性是两个蚀刻速率之间的比率 , 通常是被蚀刻的材料和掩模之间的比率 , 通常 , 选择性越大 , 掩模越垂直 , 就越容易蚀刻垂直轮廓 , 选择性可以通过选择遮罩进行调整:硬遮罩或软遮罩 , 软指的是光致抗蚀剂掩模 , 而硬指的是金属(例如镍、铬、铝)或电介质 , 例如氧化硅或氮化硅 , 调整选择性的另一种方式是通过调整影响相对蚀刻速率的工艺 。
温度对大多数材料的影响是蚀刻速率的增加 , 虽然看起来选择性会随着温度的升高而保持不变 , 但并不是所有材料的蚀刻速率都会以相同的比例增加 , 一个例子是InP:在较低温度下 , InP的蚀刻速率相对较慢 , 与氧化硅相当 , 但是在高温下 , InP的蚀刻速率远远超过电介质掩模的蚀刻速率 , 另一个例子是用氧化硅掩模蚀刻硅 , 在这种情况下 , 选择性随着温度的升高而降低 。
衬底温度与所谓的“热预算”相关 , 热预算指的是样品在加工过程中可以承受的高温 , 例如 , 如果温度过高 , 一些需要蚀刻的磁性材料可能会失去一些独特的性能 , 光致抗蚀剂或临时晶片结合材料可能会限制处理温度 。 每个应用都有特定的温度要求 , 选择能够在您的温度范围内准确提供结果的设备是一个至关重要的考虑因素 。
表面形态是指表面的微观粗糙度 , 并非所有的应用都要求表面具有原子级的光滑度 , 说一个曲面光滑只是相对而言的 , 好在有计量学可以让形态学定量化 , 原子力显微镜可以测量亚埃范围内的粗糙度(光滑度) , 白光干涉测量法也用于观察物体表面的细节 , 扫描电子显微镜图像有时可以提供定量信息 , 但在比较表面时效果更好 , 侧壁形态是许多光子器件如波导和边发射激光器的相关度量 , 然而 , 通常难以量化蚀刻的影响并将其与初始掩模粗糙度分开 。
还有实际测量损害的挑战 , 简单地构建一个设备并观察到其性能不如预期是费力的 , 并且可能令人沮丧 , 通常需要试验车辆和多种分析技术来明确识别损伤源 , 作为替代 , 建议对可能的损坏机制以及它们如何影响设备有所了解 , 例如 , 具有铰接结构的微机电系统(MEMS)装置可能不会受到紫外线辐射产生的等离子体的影响 , 有时 , 通过表面分析计量(例如能量分散X射线分析)可以很容易地得到答案 , 而其他时候 , 通过衬底偏压控制离子能量就可以得到答案 , 由于损伤的复杂性质和发现其来源的困难度量 , 它很少作为一个规范包括在内 。
可重复性代表使用相同设备多次获得相同结果的能力 , 类似于晶片内的均匀性 , 可重复性指的是批次间的测量 , 与均匀度一样 , 通常使用标准偏差计算或((最大–最小)/ (2 x平均值))表达式来定量定义该参数 , 它通常被称为晶片间的一致性 。
【蚀刻性能:需要考虑的 9 个因素】
推荐阅读
- 也许误会外星人的飞行器了,它根本不需要引擎,比想象中的还要高级
- 炒股交易,需要自我反省……
- 云南发现近危级珍稀植物水晶兰,不需要光合作用,靠真菌吸收养分
- 登月一次需要发射16枚星舰?14架全是加油机,关键技术八字没一撇
- 研究者发现量子计算可将光线追踪的性能提高190%
- 案例:重婚罪与非法同居的认定标准是什么?非法同居需要哪些证据
- 一年至少要吃3000只蚊子,需要8年才能长大,却被人们恶意捕食
- 在交易中保持盈利,你需要培养概率思维的刻意练习方法
- 在超临界二氧化碳中蚀刻氧化硅薄膜
- 人造卫星在入轨之后,还需要继续加速吗?



